(邦訳:劣化緩和と故障回避によるVLSI高信頼化に関する研究)
| 郡浦 宏明 (株)日立製作所 横浜研究所 |
[背景]人々は微細化・高集積化が進むVLSIがもたらした高度情報化社会への依存度を高めている
[問題]宇宙・電力などのミッションクリティカルな分野におけるVLSIの高信頼・長寿命化
[貢献]ユーザに信頼性の問題を意識させることなく長期間継続使用可能な高信頼VLSIの実現に寄与
[問題]宇宙・電力などのミッションクリティカルな分野におけるVLSIの高信頼・長寿命化
[貢献]ユーザに信頼性の問題を意識させることなく長期間継続使用可能な高信頼VLSIの実現に寄与
ここ数十年間,VLSIはムーアの法則に従って絶えず微細化・高集積化され,情報システムの著しい進歩に貢献してきた.今日,人々がさらに情報システムへの依存度を高めているなかで,長期間にわたるVLSIの高信頼性の保証はVLSI設計者の責務となっている.また,トランジスタが微細化されるにつれてトランジスタの性能低下・故障を招く経年劣化現象への感度が増加している.代表的な経年劣化現象の1つの負バイアス温度不安定性(NBTI) は,PMOSFETの閾値電圧を劣化させ回路の遅延故障を引き起こすため,問題とされている1).とりわけ,宇宙・電力などのミッションクリティカルな分野においては,NBTIなどの経年劣化を克服した高信頼・長寿命なVLSIが待望されている.そこで,劣化緩和と故障回避によるVLSIの高信頼化を目的とした研究を進めた.
目的達成のために,まずはVLSIの時間経過に伴う劣化進行の理解が必要である.まずVLSIは出荷前にバーンインテストと呼ばれる,高負荷下での回路の正常動作を確認するテストを受ける.それに合格したもののみが晴れて製品に搭載されて出荷される.その後,VLSIを構成するトランジスタや配線では,使用時間や使用環境などに依存して経年劣化が進行していく.経年劣化の進行度が閾値を超えると,トランジスタの特性劣化による回路遅延の増大や,トランジスタや配線がショート・欠損する物理的故障により,回路が正常動作しなくなる.
そこで,まずはこれらの期間を通じて経年劣化の影響を事前に予測するための研究が必要だと考えた.影響が大きいと考えられているNBTIに注目し,劣化進行を高精度で予測するためにトランジスタ単位のストレス状況を見積もる手法を提案し,適用効果を評価した.
次に,経年劣化の影響を抑制・緩和して故障発現を遅らせる研究を行った.集積回路が処理を行っていない時間帯(スタンバイ時間)を利用し,NBTIによるトランジスタのストレス緩和に寄与するような入力を与える手法を提案し,その有効性を評価した.
また,経年劣化が進み故障が発生したときには,自律的な故障個所の迂回・回避によって回路寿命を延長させることができる.こうした研究がすでに複数存在するなかで,長寿命化や安定した寿命の確保などユーザの目的に応じた高信頼化を達成するために,各手法の特徴を事前に同じ指標のもとで評価する必要があると考えた.そこで,代表的な故障回避手法2)について故障回避シミュレーションを行い,寿命延長効果やスペア回路の使用効率などの特徴を明らかにした.
本研究はVLSIの微細化・高集積化により顕在化する劣化故障の除去を実現するという点において非常に有用である.本成果は,ユーザに信頼性の問題を意識させることなく長期間継続使用可能な高信頼VLSIの実現に寄与するものと期待できる.
目的達成のために,まずはVLSIの時間経過に伴う劣化進行の理解が必要である.まずVLSIは出荷前にバーンインテストと呼ばれる,高負荷下での回路の正常動作を確認するテストを受ける.それに合格したもののみが晴れて製品に搭載されて出荷される.その後,VLSIを構成するトランジスタや配線では,使用時間や使用環境などに依存して経年劣化が進行していく.経年劣化の進行度が閾値を超えると,トランジスタの特性劣化による回路遅延の増大や,トランジスタや配線がショート・欠損する物理的故障により,回路が正常動作しなくなる.
そこで,まずはこれらの期間を通じて経年劣化の影響を事前に予測するための研究が必要だと考えた.影響が大きいと考えられているNBTIに注目し,劣化進行を高精度で予測するためにトランジスタ単位のストレス状況を見積もる手法を提案し,適用効果を評価した.
次に,経年劣化の影響を抑制・緩和して故障発現を遅らせる研究を行った.集積回路が処理を行っていない時間帯(スタンバイ時間)を利用し,NBTIによるトランジスタのストレス緩和に寄与するような入力を与える手法を提案し,その有効性を評価した.
また,経年劣化が進み故障が発生したときには,自律的な故障個所の迂回・回避によって回路寿命を延長させることができる.こうした研究がすでに複数存在するなかで,長寿命化や安定した寿命の確保などユーザの目的に応じた高信頼化を達成するために,各手法の特徴を事前に同じ指標のもとで評価する必要があると考えた.そこで,代表的な故障回避手法2)について故障回避シミュレーションを行い,寿命延長効果やスペア回路の使用効率などの特徴を明らかにした.
本研究はVLSIの微細化・高集積化により顕在化する劣化故障の除去を実現するという点において非常に有用である.本成果は,ユーザに信頼性の問題を意識させることなく長期間継続使用可能な高信頼VLSIの実現に寄与するものと期待できる.
1)M. A. Alam, et al.,: A comprehensive model for PMOS NBTI degradation: Recent progress, Microelectronics Reliability, Vol.47, No.6, pp.853–862 (2007).
2)M. G. Parris, et al.: Progress in autonomous fault recovery of field programmable gate arrays, ACM Computing Surveys, Vol.43, No.4, pp.31:1–31:30 (2011).
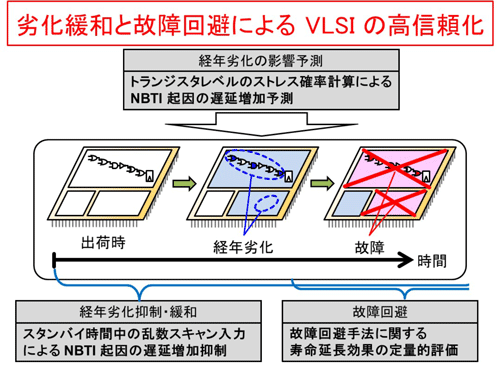
高信頼なVLSIのコンセプト
(2014年6月9日受付)

